
XPSとは
XPSとは
原理
X線光電子分光法(XPS:X-ray Photoelectron SpectroscopyまたはESCA:Electron Spectroscopy for Chemical Analysis)は、試料表面にX線を照射し、試料表面から放出される光電子の運動エネルギーを計測することで、試料表面を構成する元素の組成、化学結合状態を分析する手法です。 Al Kα線を用いるXPS装置では、一般に試料表面数nm以下に存在する元素の情報を得ることが出来ます。
また原子の価電荷(価数)や原子間の距離など、分析対象となる原子周囲の電子状態によって起こる結合エネルギーの変化(化学シフト)はAESで観察される化学シフトよりも大きな場合が多く、化学結合状態を比較的容易に識別可能であることもXPSの特長と言えます。
 |
 |
励起源(走査型マイクロフォーカスX線源)
光電子の励起源には、一般的にAl Kα線、Mg Kα線などの特性X線が広く用いられています。走査型マイクロフォーカスX線源は、単色化されたAl Kα線を細く絞って試料上で走査可能なX線源です。X線ビーム径は数µmφから数百 µmφの範囲で設定することができ、また走査範囲も任意に変更可能であることから、試料に合わせて最適な分析領域で測定することができます。この機能を利用した二次電子像観察(SXI : Scanning X-ray Image)により迅速かつ正確な分析位置指定も可能です。また多点同時分析、大面積測定、線分析、面分析など、多様な分析に対応しています。
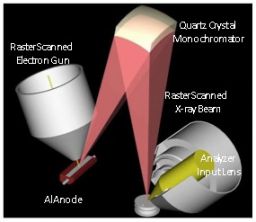 |
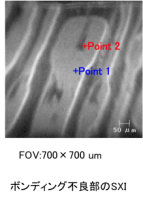 |
 |
帯電補償機構(デュアルビーム帯電中和)
XPSは導電物から絶縁物まで幅広い固体試料の元素・化学状態分析に用いられますが、絶縁物試料では光電子の発生により、X線照射領域において正の帯電が起こります。正に帯電した状態で計測されたスペクトルは、本来の位置より高結合エネルギー側(低運動エネルギー側)にシフトするため、正しいエネルギー位置を読み取ることが困難になります。このため、絶縁物試料では測定中の帯電中和が必要です。低エネルギーの電子線とイオンビームを同時に照射するデュアルビーム手法は表面の不均一帯電が自己修復的に安定する中和方法であるため、広範囲の絶縁物にも安定した帯電中和を行うことができます。また微小部分析では必須の機能であると言えます。

スパッタイオン銃(アルゴンイオン銃、クラスターイオン銃)
XPSで評価可能な情報深さは表面から数 nmの領域であるため、表面汚染層が厚い場合や、より深い領域を評価したい場合は、イオンスパッタリングを利用して表面エッチングを行います。スパッタと測定を交互に繰り返して得られたスペクトル情報から元素の組成もしくは化学結合状態について深さ方向プロファイルを得ることが可能となります。深さ方向プロファイルは多層構造をもつ試料の膜厚評価や、金属の変色・腐食の原因解析などに利用されています。一般に金属・半導体など無機材料の深さ方向分析にはアルゴン(Ar)イオンが、有機材料に対しては、フラーレン(C60)やアルゴンガスクラスターイオン(Ar-GCIB)が用いられ、材料や目的によってスパッタイオン銃を使い分けます。
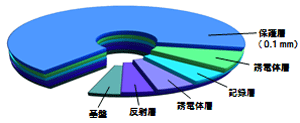 |
|
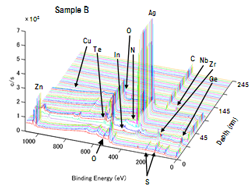 |
 |



