半導体
半導体
集積回路はパターニングされた薄膜が積層されてデバイスとしての機能を発揮しています。表面分析装置は薄膜や微細構造の組成分析あるいは汚染物質やプロセス残留物の同定を通じて、新材料やプロセスの開発と歩留まりの向上に欠かせない役割を果たします。
欠陥の同定(オージェ電子分光分析装置)
ナノサイズの欠陥に対して元素分析によりこれを同定して、その原因を明らかにすることは、エッチング工程での歩留まり向上に極めて重要です。プロセスルールの縮小により、より小さな欠陥が問題となり、光学検出とEDX分析による従来方法では極薄膜や極微細欠陥の検出同定が容易ではなくなってきました。オージェ電子分光分析装置はこのような状況下で有益なツールです。

図1: 50nmの異物はアルミニウムからなることが判明しました。

図2: FIB切断により露出した埋蔵物は二酸化ケイ素がケイ素に覆われたものであることが判明しました。異物はポリシリコン工程で発生し、タングステン工程を経たものとわかります。
痕跡金属汚染
痕跡程度の微量な金属汚染が、半導体デバイスの特性に致命的な影響を与えることがあります。特許取得のTRIFT型アナライザを持つアルバック・ファイのTOF-SIMS装置は、低いバックグラウンドノイズと高い質量分解能を持ち、痕跡金属汚染に対して(市販装置)最高の感度と高質量分解能による優れた同定能力を有します。
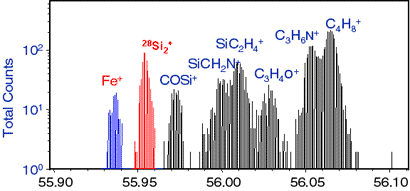
図3: 15,000を超える質量分解能は、例えば質量数56のピークを28Si2+と不純物金属や有機物に分離検出できます。
極浅打ち込み層の深さ分析
今日の高性能素子の作製に極浅打ち込み技術は広く用いられています。アルバック・ファイのダイナミックSIMS装置 PHI ADEPT-1010™は極浅打ち込みに対して安定した自動分析を行い、極浅打ち込みプロセス管理に役立ちます。

図4: 500eVで打ち込まれた硼素の濃度分布を500eVの酸素イオンビームでスパッターしながら求めたもの。
ボンディングパッドの表面組成(XPS)
ボンディングパッド表面の組成と化学状態はデバイスの寿命と物理的、電気的特性を左右します。このような理由から、多くの半導体製造業者はXPSでボンディングパッドの組成を監視しています。マイクロフォーカスX線源を備えた PHI Quantera II™ は微小領域で高感度XPS分析が可能で、最先端のボンディングパッドのように20μm程度に加工された領域の化学分析を行うことができます。
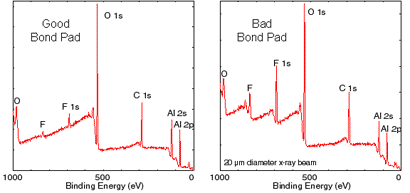
図5: アルミニウムのボンディングパッドのX線光電子スペクトルから表面酸化膜とフッ素化合物からなる異物の存在がわかりました。フッ素濃度が高いことからアルミニウムのボンディングパッドの腐食が疑われました。



